在一台厚度只有 14.95mm、重量只有 1.08kg 的笔记本上,从主板、电池到散热,绝大多数的结构空间和重量都已经被「榨干」了,但有一个东西做薄的难度可能超越了很多人的想象。
3 月 19 日发布的小米 Book Pro 14,作为小米高端轻薄本的回归之作,可以说充满了惊喜。极致轻薄的精致机身、50W 的性能释放,让它真正能够成为一款好用的超轻本。但如果顺着结构往里拆,会发现一个更有意思的点:
小米 Book Pro 14 能做到这么轻薄和精致,离不开屏幕顶端几乎察觉不到的「超薄摄像头」。

图片来源:小米
公允地讲,这真的很难。摄像头既要有完整的光学结构,又要容纳传感器和封装,还要保证成像质量,这决定了它很难像其他部件一样被随意压缩。结果就是,当屏幕越来越薄、边框越来越窄,摄像头反而成了那个「最后凸出来的东西」:
成为笔记本电脑减薄「最后一毫米」的关键瓶颈。
这也是为什么,小米这次没有简单沿用传统方案,而是选择了一条更激进的路径。盛泰光电为这台机器定制了一套基于 Flip Chip EGA 的摄像头模组。换个更容易理解的说法,它做的不是「把摄像头做薄一点」,而是把摄像头内部的结构重新排了一遍。
传统笔记本摄像头大多采用 COB 方案,结构上是层层叠加:芯片、金线、PCB,再到镜头模组。这种方式成熟、稳定,但代价是厚度 不可避免地被「堆」出来。而 Flip Chip EGA 的思路,是直接从封装方式下手,把芯片倒装贴合,结合金球,同时在 PCB 上开孔,让光线可以穿过结构直达传感器。
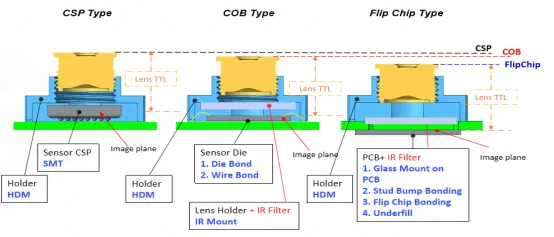
图片来源:盛泰光电
这听起来像是一次「路径优化」,但在工程上更接近一次「推倒重来」。
最终,这套方案让摄像头模组厚度相比传统方案降低约 15%。在手机行业,这样的数字可能不算极端,但在笔记本这种空间已经被压缩到极限的产品里,这 15% 很可能就是决定整机厚度能不能再降 1mm 的关键变量。
更重要的是,这个过程并不只是设计层面的调整,而是一整套制造能力的重构。
Flip Chip 封装并不是新技术,但长期以来,它更多掌握在少数几家海外厂商手中,主要服务于苹果供应链。对于国内厂商来说,这类高端封装能力既昂贵,又封闭,很难真正进入。
盛泰光电的路径,是从 2021 年开始自研攻坚,从封装应力控制、热管理设计到良率爬坡,一步步把这套工艺做出来。这背后不是某一个「黑科技突破」,而是一整段典型的高端制造爬坡过程:反复试错、参数验证、设备定制,直到可以稳定量产。
从这个角度来看,这颗摄像头的意义,已经不只是「更薄」,也改变的是一件更底层的事情:中国厂商也能提供这种能力。
过去,类似规格的超薄摄像头模组,基本等同于「苹果供应链能力」。而现在,小米等更多厂商可以在自己的产品上用上国产方案,并且实现量产。
事实上,从 2023 年至今,华硕、小米、传音、长城等顶级终端厂商都在高端旗舰机型上采用了盛泰的 FC-EGA 超薄摄像头。
回到产品本身,盛泰光电为小米 Book Pro 14 定制的超薄摄像头,实际上不只是「超薄」,更没有牺牲成像能力,依然是 FHD 级别,同时又让屏幕边框可以更窄、整机结构可以更薄。
再把视角拉远一点,过去关于「国产替代」的讨论,大多集中在芯片、面板、存储这些更显性的领域。但像摄像头封装这样的「结构工艺层」,反而更难突破,因为它既依赖长期工艺积累,又高度绑定终端产品设计。
而小米 Book Pro 14 这颗摄像头,恰恰发生在这一层。
这也进一步说明了高端硬件的竞争,在逐渐转向更底层的制造能力。谁能把这些看不见的环节做好,谁就更有机会把产品做得更极致。

 雷科技
雷科技





































